MicroLED技术工艺按照实现方式的不同,可以分为芯片级焊接外延级焊接和薄膜转移三种:
芯片级焊接(chipbonding):将LED直接进行切割成微米等级的MicroLEDchip,再利用SMT技术或COB技术,将微米等级的MicroLEDchip一颗一颗键接于显示基板上。
参考观研天下发布《2018-2024年中国LED产业市场竞争现状调查及未来发展趋势预测报告》
外延级焊接(waferbonding):在LED的磊晶薄膜层上用感应耦合等离子离子蚀刻(ICP),直接形成微米等级的Micro-LED磊晶薄膜结构,再将LED晶圆(含磊晶层和基板)直接键接于驱动电路基板上,,最后使用物理或化学机制剥离基板,仅剩Micro-LED磊晶薄膜结构于驱动电路基板上形成显示划素。
薄膜转移:通过剥离LED基板,以一暂时基板承载LED外延薄膜层,再利用感应耦合等离子蚀刻,形成微米等级的MicroLED外延薄膜结构;或者先利用感应耦合等离子离子蚀刻,形成微米等级的MicroLED外延薄膜结构,通过剥离LED基板,通过暂时基板承载LED外延薄膜结构。

目前以索尼为代表的microLED大屏应用主要采用芯片级焊接的方式;而苹果则在推动薄膜转移技术,该技术作为中小尺寸显示更为合适。在此我们仅对苹果拟采用的薄膜转移技术作介绍:MicroLED薄膜转移技术流程可以简单描述为1)MicroLED芯片制备;2)MicroLED芯片转移;3)搭载TFT基板和驱动IC,既而完成产品封装。
MicroLED芯片制备,倒装工艺是大趋势
MicroLED芯片制备流程与传统LED芯片类似,仅以蓝绿光芯片为例介绍生产流程:通过在蓝宝石衬底材料上进行PSS图形衬底、LED外延生长、芯片加工处理等技术环节,出产LED芯片。MicroLED芯片从尺寸上相对普通LED芯片小得多(几微米),但是现有的刻蚀技术完全可以处理微米级别的芯片,从技术上并不存在特别大的难点。以下仅对LED芯片生长的各环节作简要介绍:
蓝宝石衬底生长外延片(蓝绿光LED正装芯片)
首先对蓝宝石材料进行PSS图形化衬底,该步骤的目的是通过在蓝宝石衬底表面上刻蚀出规则排列的圆锥体来实现光在衬底内的多次反射,从而达到芯片外部光的取光效率的提升。此后在PSS层上依次生长非掺杂缓冲层(U-GaN)、N型氮化镓(N-GaN)、有源层(MQWs,多量子阱)、P型氮化镓层(P-GaN)。
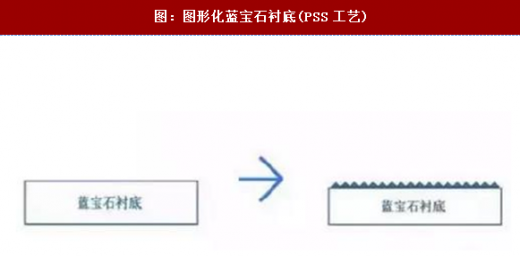
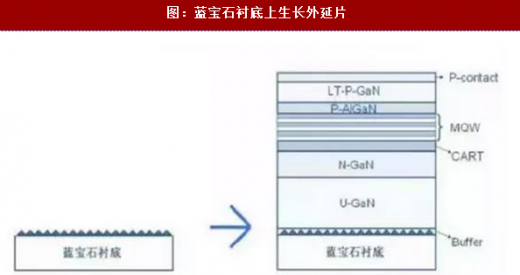
LED外延片再经过一系列光刻、台阶刻蚀、ITO蒸镀、电极制作、保护层蒸镀、衬底减薄、背镀反射层等工艺,形成LED芯片结构。
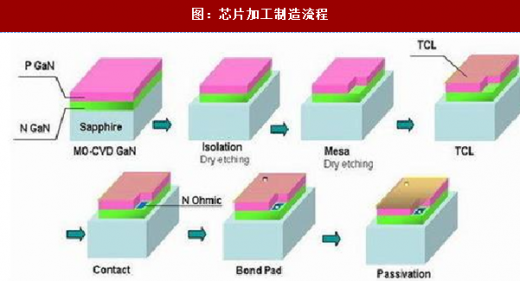
LED芯片结构分为正装结构,垂直结构和倒装结构。由于垂直结构应用较少,此处仅讨论正装结构和倒装结构。相对正装LED芯片,倒装LED芯片自下而上分别为蓝宝石衬底、N型GaN层、有源层、P型GaN层、金属层、P电极和N电极。倒装结构与正装结构主要差别:1)倒装芯片正负电极可以设计在一个平面上,使连接更方便;2)LED倒装芯片电极与电极间不需要金线连接,正负极直接与基板接触,结构更简单,且可靠性提高;3)剥离蓝宝石基板,取光效率增加。
MicroLED后续制作过程中,将通过转移技术,使芯片的正负电极直接与基板连接。由于芯片尺寸非常小,留给正装芯片的引线布线空间不足,故我们预计MicroLED将更可能采用电极和基板直接键合的形式,这个形式就非常类似于芯片的倒装封装结构,只是芯片倒装封装结构是封装一颗灯珠,而MicroLED显示屏是将数颗MicroLED灯珠先与基板直接连接,再进行封装。
从芯片角度看,直接将芯片的正负极与基板连接,当然可以把正装芯片倒过来,用正装芯片实现倒装封装形式。但是1)正装芯片的p电极和n电极不在一个平面上,要用正装芯片实现倒装封装,需要制作特殊的金属凸点,使不在一个平面上的p电极和n电极与基板相连;2)此外正装芯片包含金线,本身结构也更复杂,影响LED灯珠的出光效果。我们预期MicroLED将采用正负极在一个平面上,且出光效率更高的类倒装芯片结构。而除了倒装结构外,垂直结构LED芯片也比较适合做为MICROLED,在此不作展开。
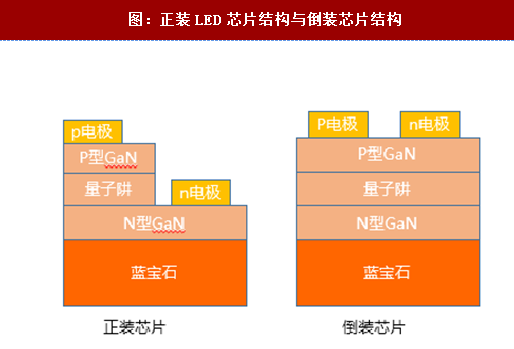

MicroLED芯片转移技术介绍
MicroLED芯片为何要转移?传统的LED显示屏在芯片切割完毕后,直接对整颗LED灯珠进行封装,驱动电路与芯片正负极连接,驱动封装好的灯珠;而MicroLED在光刻步骤后,并不会直接封装,这是由于封装材料会增大灯珠体积,无法实现灯珠间的微距。需要将LED裸芯片颗粒直接从蓝宝石基板转移到硅基板上,将灯珠电极直接与基板相连。
目前MicroLED转移的技术有范德华力、静电吸附、相变化转移和雷射激光烧蚀四大技术。其中范德华力、静电吸附及雷射激光烧蚀方式是目前较多厂商发展的方向,但是elux的专利布局是在相变化修复及转移的技术方面,较其他公司的转移技术有着不同之处。
Luxvue采用离子薄膜转移技术进行MicroLED的灯珠转移,首先将灯珠金属层与临时基板进行贴合,通过范德华力、静电吸附及雷射激光烧蚀等方式以吸附MicroLED灯珠。此后,通过物理或化学腐蚀的方法,除去蓝宝石基板,仅保留此前光刻后成型的MicroLED灯珠。之后将生成好的灯珠向硅基板上转移,完成MicroLED显示屏的制备。
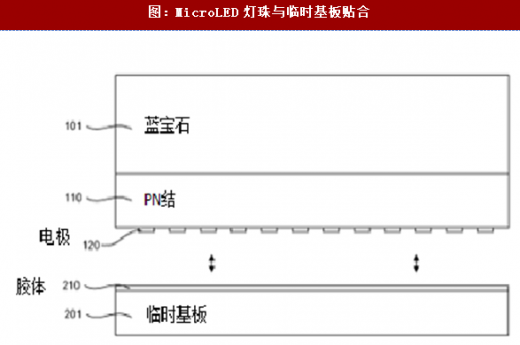

整个流程听上去很简单,但是整个转移的过程却有很多的难点:
1)MicroLED芯片需要进行多次转移(至少需要从蓝宝石基板->临时基板->硅基板),且每次转移灯珠量非常大,对转移工艺的稳定性和精确度要求非常高。
2)对于RGB全彩显示而言,由于每一种工艺只能生产一种颜色的灯珠芯片,故需要将红色、蓝色、绿色灯珠芯片分别进行转移,需要非常精准的工艺进行灯珠的定位,极大的增加了转移的工艺难度。
MICROLED彩色化——批量转移
市面上已经有较为成型的灯珠批量转移技术:美国企业X-Celeprint针对芯片转移工艺,已经成功的推出了μTP技术,利用该技术可以将大量小型器件(如MicroLED灯珠)在同一时间内进行精确移动。μTP技术简单的来说,就是使用弹性印模结合高精度运动控制打印头,有选择的拾取微型元器件的阵列,并将其打印到目标基板上。该技术可以通过定制化的设计实现单次拾取和打印多个器件,从而短时间内高效的转移成千上万个器件,这项工艺流程可以实现大规模并行处理,实现批量MicroLED转移。
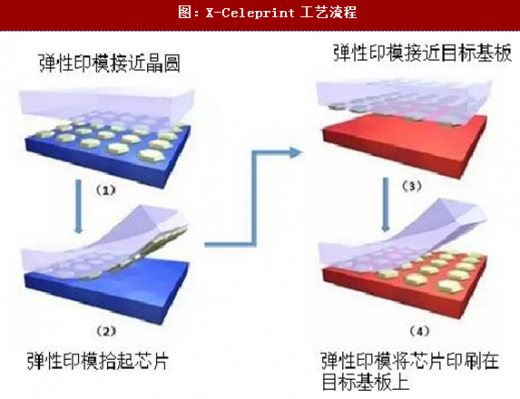
MICROLED彩色化的替代方案
由于采用3色LED灯珠进行转移较为复杂,市场上诞生了诸多MicroLED替代方案:如Leti推出的iLEDMatrix采用量子点进行全彩显示,此种方法主要是利用紫外microLED发出的光来激发红绿蓝三色的发光介质,如荧光粉或量子点,产生不同颜色的光,并进行配比实现全彩色。这种方式只需要单色LED灯珠即可实现全彩显示,简化LED灯珠转移过程。白光LED+量子点技术或在全彩LED技术成熟前,成为一种良好的替代方案。其他的MicroLED彩色化方案还包括光学棱镜合成法等。
MicroLED驱动方式:主动+被动
类似于LCD显示屏,MicroLED驱动方式也分为被动矩阵驱动方式和主动矩阵驱动方式(TFT)两种结构。LED电极通过金属键合工艺实现与硅基的CMOS驱动背板连接。在被动式矩阵驱动方式中,由一组水平像素共用同一性质的一个电极,一组垂直像素共用同一性质的一个电极,组成矩阵型结构,制作成本和技术门槛较低。在主动式矩阵驱动方式中,将像素的阴极共用N型GaN层形成连接,所有像素的阳极与硅基CMOS驱动背板进行金属键合,形成每个像素单独寻址、独立控制。



【版权提示】观研报告网倡导尊重与保护知识产权。未经许可,任何人不得复制、转载、或以其他方式使用本网站的内容。如发现本站文章存在版权问题,烦请提供版权疑问、身份证明、版权证明、联系方式等发邮件至kf@chinabaogao.com,我们将及时沟通与处理。









